Wirebond
ASECL Package Milestone
• Wide Matrix Conversion on SOP & QFP
• Big Strip MAP BGA Program
• EPP(Green) Program
• 90 & 65 nm Wafer Technology Development
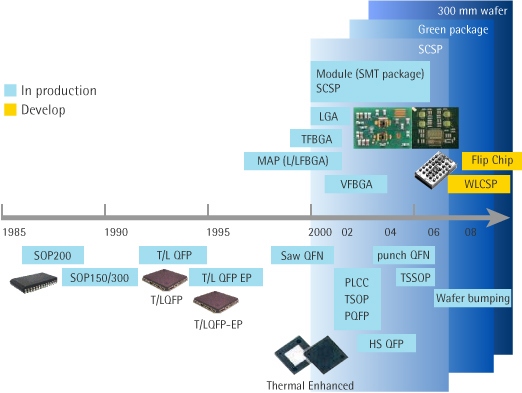

L/T/V/W(F)BGA (MAP BGA)
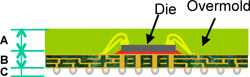 |
 |
| (Dimension in mm) | L/LF BGA | T/TF BGA | VF BGA | WFBGA | |||
| Total Thickness | 1.6 max | 1.3 max | 1.2 max | 1.0max | 0.7 max | ||
| A | Mold cap | 0.8 | 0.7 | 0.54 | 0.45 | 0.37 | 0.25 |
| B | Substrate | 0.36 | 0.26 | 0.26 | 0.22 | 0.22 | 0.15 |
| C | Ball Size | 0.5/0.4 | 0.4/0.3 | 0.4/0.3 | 0.3 | 0.3 | 0.3 |
| Package Size | 3x3 ~ 27x27. Single mold cap design. | ||||||
| Package I/O | 10 ~ 600 I/Os. Various ball count toolings available. | ||||||
| Solder ball pitch | 1.27/ 1.0/ 0.8/ 0.75/ 0.65/ 0.5 mm | ||||||
| Substrate layers | 2 / 4 / 6 layers, Laminated or build-up substrate available. OSP is options |
||||||